- 04/01
- 2025
-
QQ扫一扫

-
Vision小助手
(CMVU)
3D结构光相机在半导体封装检测中的应用
半导体芯片封装(IC Packaging)是将芯片(Die)保护并连接到外部电路的过程,旨在确保芯片正常工作、提高可靠性,同时满足散热和机械强度的需求。
封装方式:
1. 传统引线框架封装
DIP:双列直插,早期计算机和MCU。SOP:小型封装,消费电子和存储芯片。QFP:四方扁平,高引脚密度。
2. 基板封装
BGA:球栅阵列,适用于高密度芯片(CPU、GPU)。CSP:芯片级封装,尺寸接近裸芯片。
3. 高级封装
Flip Chip:芯片正面朝下,提升散热和集成度。SiP:多个芯片集成,适用于智能手机SoC。3D封装:芯片堆叠,利用硅通孔(TSV)提高集成度。
应用一:QFP/SOP针脚3D检测
Application 1: QFP/SOP Pin 3D Inspection
QFP(Quad Flat Package)和SOP(Small Outline Package)封装的芯片金属针脚(Lead)3D检测是确保芯片与PCB连接质量的关键步骤。采用3D高精度结构光相机对金属针脚进行立体扫描,可以精准检测引脚的高度、角度、弯曲情况等,有助于发现不易察觉的缺陷。3D技术的使用特别适合QFP封装,因为它可以更好地捕捉针脚的形态和位置。
相机选型
相机型号: 高精度迅猛龙VRH系列 VRH9-040B;分辨率:907万3D点云;扫描范围(Z向):243~257 mm;近视场(工作距离):43x22 mm(243);中视场(工作距离):47x25 mm(250);远视场(工作距离):49x26 mm(257);XY轴分辨率:11 µm;Z轴重复精度:1.2 µm;最快扫描速率:11.6 fps;最佳扫描体积:47x25x14 mm。
成像效果
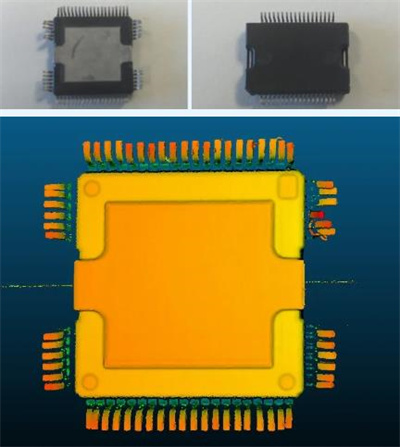

应用二:BGA芯片焊球3D检测
Application 2: 3D inspection of BGA chip solder balls
BGA(Ball Grid Array)封装芯片的3D高度测量是非常关键的一步,尤其是在进行焊接质量检测、装配过程控制、以及保证焊点的可靠性时。BGA芯片的焊球与PCB的连接通常位于芯片底部,因此其3D高度测量需要非常精确,通常采用高精度的3D测量技术来确保封装与焊接的质量。
相机选型
相机型号: 高精度迅猛龙VRH系列 VRH9-020B;分辨率:907万3D点云;扫描范围(Z向):112~114.5 mm;近视场(工作距离):24.1x12.2 mm(112);中视场(工作距离):24.3x12.4 mm(113);远视场(工作距离):24.6x12.7 mm(114.5);XY轴分辨率:5.5 µm;Z轴重读精度:0.6 µm;扫描速率:1.4 fps;最佳扫描体积:24.3x12x2 mm。
成像效果



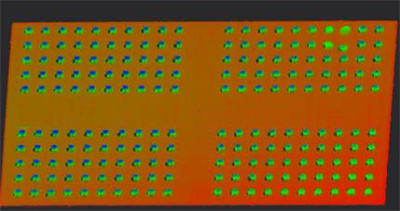
应用三:Wafer Bump晶圆焊盘凸点3D测量
Application 3: 3D measurement of wafer solder pad bumps
Wafer Bump 3D测量是半导体制造中用于检测晶圆上焊盘凸点(Bump)的三维形态和质量的关键步骤。晶圆凸点主要用于芯片高级封装中,它们连接芯片与封装基板。对这些凸点的3D测量能确保焊点的高度、形状、平整度和位置精度,以避免封装中的电气和机械问题。
相机选型
相机型号: 霸王龙TRS系列 TRS-010B;分辨率:2600万3D 点云;扫描范围(Z向):1 mm;近视场(工作距离):9.75x9.75 mm(61.5);中视场(工作距离):9.8x9.8 mm(62);远视场(工作距离):9.85x9.85 mm(62.5);XY轴分辨率:1.9 μm;Z轴重复精度:0.21 µm;最佳工作距离:62 mm;最佳扫描体积:9.8x9.8*1 mm。
成像效果